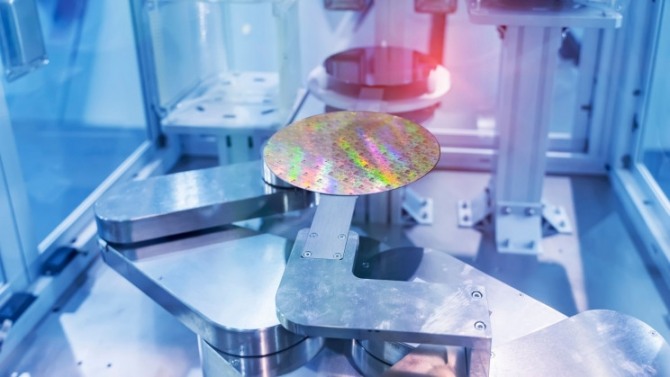 이미지 확대보기
이미지 확대보기IBM은 3D 적층 칩을 더욱 쉽게 생산할 수 있는 프로세스를 고안했다고 밝혔지만 이 기술이 언제 준비될지 확인할 수는 없다.
빅 블루는 IBM의 애칭으로 제품·상표 색깔에서 나온 말이며 도쿄 일렉트론은 반도체 및 디스플레이 제조 장치를 연구, 개발, 생산하는 일본 굴지의 대기업이다.
칩 스태킹은 고대역폭 메모리와 같은 제품에 주로 사용되지만 IBM은 단일 칩에 펼쳐진 평탄한 영역보다는 주어진 부피에 들어갈 수 있는 트랜지스터의 수를 확장해 무어의 법칙의 끝을 비켜갈 가능성이 있다고 보고 있다.
무어의 법칙의 끝은 주로 제조 공정이 잠재적으로 실리콘의 물리적 한계에 접근하는 방식을 의미하며 2nm 공정 노드는 향후 몇 년 내에 온라인 상태가 될 것으로 예상된다.
수직으로 적층된 칩을 제조하려면 생산 공정 중에 깨지기 쉬운 실리콘 웨이퍼가 캐리어 웨이퍼에 부착되어야 한다. IBM에 따르면 이러한 캐리어 웨이퍼는 실리콘으로도 만들 수 있지만 처리 후 이를 분리하려면 기계적 힘이 필요하기 때문에 웨이퍼가 손상되고 수율이 감소할 수 있다. 이러한 이유로 생산 웨이퍼에 일시적으로 접착하고 자외선 레이저를 사용하여 접착을 제거할 수 있으므로 일반적으로 유리가 사용된다.
IBM과 도쿄 일렉트론(Tokyo Electron)은 실리콘을 분리할 수 있는 적외선 레이저를 사용하는 새로운 공정을 개발했다고 밝혔다. 이는 표준 실리콘 웨이퍼를 유리 대신 캐리어로 사용할 수 있음을 의미한다. 이는 유리가 필요 없어 생산 공정을 단순화할 뿐만 아니라 도구 호환성 문제의 제거, 결함 감소 및 웨이퍼의 인라인 테스트 가능과 같은 다른 이점도 있다고 주장한다.
우리는 이 새로운 프로세스가 실제로 생산 3D 스택 칩을 제공할 준비가 되어 있는지에 대해 IBM에 문의했지만 그들로부터 즉시 응답을 듣지 못했다. 아무리 해도 테스트 시스템이 사용 가능한 상업적 프로세스로 전환되기까지는 최소한 몇 년은 걸릴 것으로 보인다.
김세업 글로벌이코노믹 기자












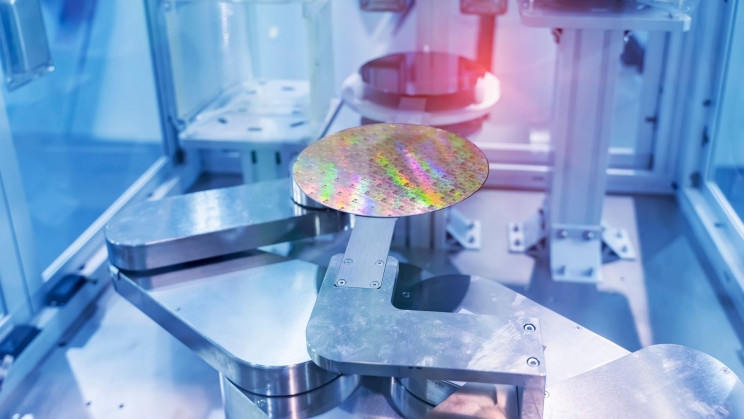


















![[영상 시승] 전기차 고민이라면? 그냥 아이오닉 5 사~! 2024년형...](https://nimage.g-enews.com/phpwas/restmb_setimgmake.php?w=80&h=60&m=1&simg=2024042707324903509c35228d2f5175193150103.jpg)
![[뉴욕증시] 알파벳·엔비디아 폭등에 3대 지수 일제히 상승](https://nimage.g-enews.com/phpwas/restmb_setimgmake.php?w=80&h=60&m=1&simg=2024042705504802175c35228d2f5175193150103.jpg)
























