TSMC, AI칩 주문 포화로 공급 한계…테슬라, 공급망 위험 분산 착수
삼성 2나노 전공정·인텔 EMIB 후공정 '이례적 협력'…반도체 지각변동 예고
삼성 2나노 전공정·인텔 EMIB 후공정 '이례적 협력'…반도체 지각변동 예고
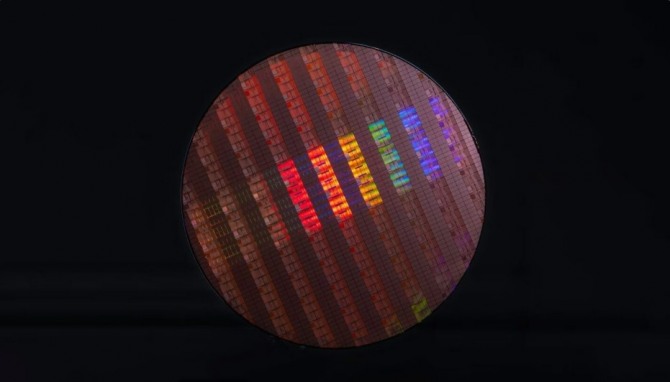 이미지 확대보기
이미지 확대보기IT 전문 매체 WCCF테크는 지난 7일(현지시각) 테슬라가 삼성 파운드리에 2나노(nm) 공정 기반의 차세대 AI6 칩 전공정 생산을 의뢰했으며, 도조 슈퍼컴퓨터의 칩 패키징과 최종 테스트는 인텔 파운드리에 맡겼다고 보도했다.
◇ TSMC 떠나는 테슬라, 이유는?
테슬라의 이런 결정은 기존 핵심 협력사였던 TSMC의 공급망 한계 때문이다. 도조 슈퍼컴퓨터에 쓰는 맞춤형 D1 칩은 개별 크기가 654mm²에 이르는 초대형 칩으로, 5x5 배열로 칩 25개가 하나의 모듈로 연결되는 독특한 구조다. 과거 테슬라는 TSMC의 첨단 SoW(System-on-Wafer) 패키징 기술을 활용했다. 하지만 지금 TSMC 생산 라인은 CoWoS(Chip-on-Wafer-on-Substrate) 같은 3D 패키징 주문이 몰려 포화됐다. 이 때문에 상대적으로 물량이 적고 맞춤 설계가 필요한 테슬라 주문을 소화하기 어려워졌다.
이런 배경에서 돌파구가 필요했던 인텔이 테슬라에 손을 내밀었다. 인텔은 자사의 첨단 2.5D 칩 패키징 기술인 EMIB(Embedded Multi-Die Interconnect Bridge)를 대안으로 제시해 수주에 성공했다. EMIB는 초소형 실리콘 브리지를 이용해 여러 반도체 칩(다이)을 수평으로 잇는 기술로, TSMC의 SoW를 대체할 효과적인 대안으로 꼽힌다. EMIB 기술은 특히 모듈성이 뛰어나 앞으로 테슬라가 추가 기능을 통합하거나 기존 칩 성능을 미세하게 조정하는 데 유리하다. 다만 업계는 현재 상용화한 EMIB 기술만으로 웨이퍼 전체를 아우르는 초대형 칩을 완전히 만들기는 어려울 것으로 본다. 인텔 또한 관련 기술 개발과 설비 투자를 함께 진행하고 있다.
◇ 삼성·인텔 '적과의 동침'…반도체 시장 구도 변화
업계는 테슬라가 의도적으로 칩 양산을 맡는 전공정과 패키징을 맡는 후공정을 분리해 공급망 위험을 분산하고 회사별 강점을 최대한 활용하는 전략을 편다고 분석한다. 이에 따라 파운드리 시장의 최대 경쟁자인 삼성전자와 인텔이 동시에 테슬라의 AI 칩을 나눠 만드는 이례적인 협력 구도가 형성될 전망이다. 인텔로서도 이번 수주는 반도체 후공정 시장에서 입지를 다지고, 앞으로 아마존, 마이크로소프트 같은 다른 대형 고객사를 유치하는 데에도 도움이 될 전망이다.
박정한 글로벌이코노믹 기자 park@g-enews.com