전통적 '다이 본더' 대체하는 신기술 공개... 2027년 시범 납품 시작
엔비디아·TSMC와 협업 가속... '소재' 넘어 '장비 사실 표준' 노린다
엔비디아·TSMC와 협업 가속... '소재' 넘어 '장비 사실 표준' 노린다
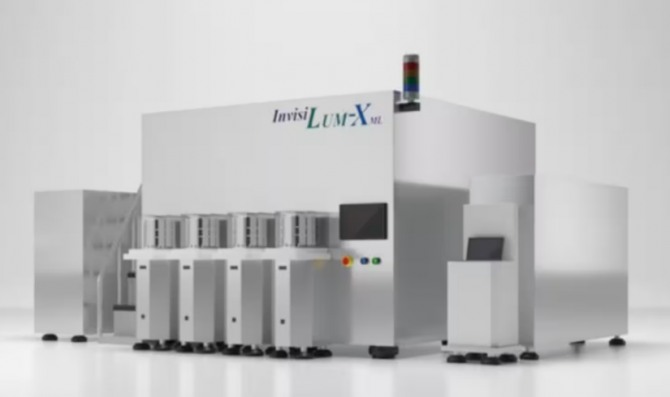 이미지 확대보기
이미지 확대보기회로 미세화가 한계에 다다르며 '패키징' 기술이 칩 성능의 핵심으로 떠오른 가운데, 신에츠는 기존 공정을 단순화하고 비용을 획기적으로 낮춘 솔루션으로 승부수를 던졌다고 8일(현지시각) 닛케이 아시아가 보도했다.
◇ "집어서 옮기지 않는다"... 다이 본더 없는 레이저 공정
기존 반도체 조립 공정에서는 웨이퍼에서 잘라낸 칩을 기계적 팔(다이 본더)로 집어 기판에 부착하는 방식을 사용했다. 이 과정에서 발생하는 열과 미세한 위치 오차는 수율 저하의 원인이 되어왔다.
신에츠가 개발한 '마이크로패브리케이션(Microfabrication)' 기술은 레이저를 이용해 웨이퍼에서 칩을 직접 분리해 기판에 장착한다.
칩을 직접 집어 운반할 필요가 없어 기계적 스트레스와 열 발생이 거의 없으며, 장착 정확도 오차를 0.1~1마이크로미터(μm) 범위 내로 유지할 수 있다. 이는 고도의 정밀함이 요구되는 차세대 AI 칩 제조에 최적화된 방식이다.
신에츠의 신기술은 경제성 면에서도 압도적이다. 기존 다이 본더 공정과 비교했을 때 자본 투자는 약 15%, 운영 비용은 약 20% 절감할 수 있다.
특히 놀라운 점은 장비 점유 공간을 80%나 줄일 수 있다는 점이다. 이는 공장 효율성을 극대화하려는 반도체 제조사들에게 매우 매력적인 요소다.
◇ '소재 강자'에서 'AI 토털 솔루션 기업'으로
신에츠는 이 기술을 바탕으로 패키지 기판 위에 직접 회로를 형성하는 '듀얼 다마신(Dual Damascene)' 공법 기반 장비 등 다양한 라인업을 구축했다. 레이저 장비 가격은 사양에 따라 수억 엔에서 10억 엔(약 90억 원) 이상이 될 전망이다.
또한, 레이저 장비뿐만 아니라 칩 보호용 수지 등 자사 특화 소재를 패키지로 묶어 판매하여 시장 점유율을 확대할 예정이다.
◇ 마이크로LED 기술의 화려한 변신
흥미로운 점은 이 기술이 본래 마이크로LED 디스플레이 제조를 위해 개발되었다는 것이다. 신에츠는 초미세 LED를 기판에 옮기는 기술이 차세대 반도체 패키징 및 칩렛(Chiplet) 아키텍처에 완벽히 적용될 수 있음을 간파하고 전략을 수정했다.
사이토 야스히코 신에츠 사장은 최근 "회사가 단순한 소재 기업을 넘어 'AI 관련주'로 거듭나길 원한다"고 밝히며, 전공정(웨이퍼, 레지스트)과 후공정(레이저 장비, 패키징 소재)을 아우르는 글로벌 반도체 표준을 정립하겠다는 포부를 드러냈다.
2027년 신에츠의 레이저 장비가 양산 현장에 도입되면, 반도체 후공정 생태계에 지각변동이 일어날 것으로 보인다.
신민철 글로벌이코노믹 기자 shincm@g-enews.com










































